
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Dislokasi dalam kristal SiC
Substrat SiC boleh mempunyai kecacatan mikroskopik, seperti Dislokasi Skru Benang (TSD), Dislokasi Tepi Benang (TED), Dislokasi Satah Asas (BPD) dan lain-lain. Kecacatan ini disebabkan oleh penyelewengan dalam susunan atom pada peringkat atom.
Kristal SiC biasanya tumbuh dengan cara yang memanjang selari dengan paksi c atau pada sudut kecil dengannya, yang bermaksud bahawa satah c juga dikenali sebagai satah asas. Terdapat dua jenis utama kehelan dalam kristal. Apabila garis kehelan berserenjang dengan satah asas, kristal mewarisi kehelan daripada kristal benih ke dalam kristal tumbuh epitaxial. Kehelan ini dikenali sebagai kehelan penembusan dan boleh dikategorikan kepada kehelan tepi berbenang (TED) dan kehelan skru berbenang (TSD) berdasarkan orientasi vektor Bernoulli ke garisan kehelan. Kehelan, di mana kedua-dua garisan kehelan dan vektor Brönsted berada dalam satah asas, dipanggil kehelan satah asas (BPD). Hablur SiC juga boleh mempunyai kehelan komposit, yang merupakan gabungan kehelan di atas.
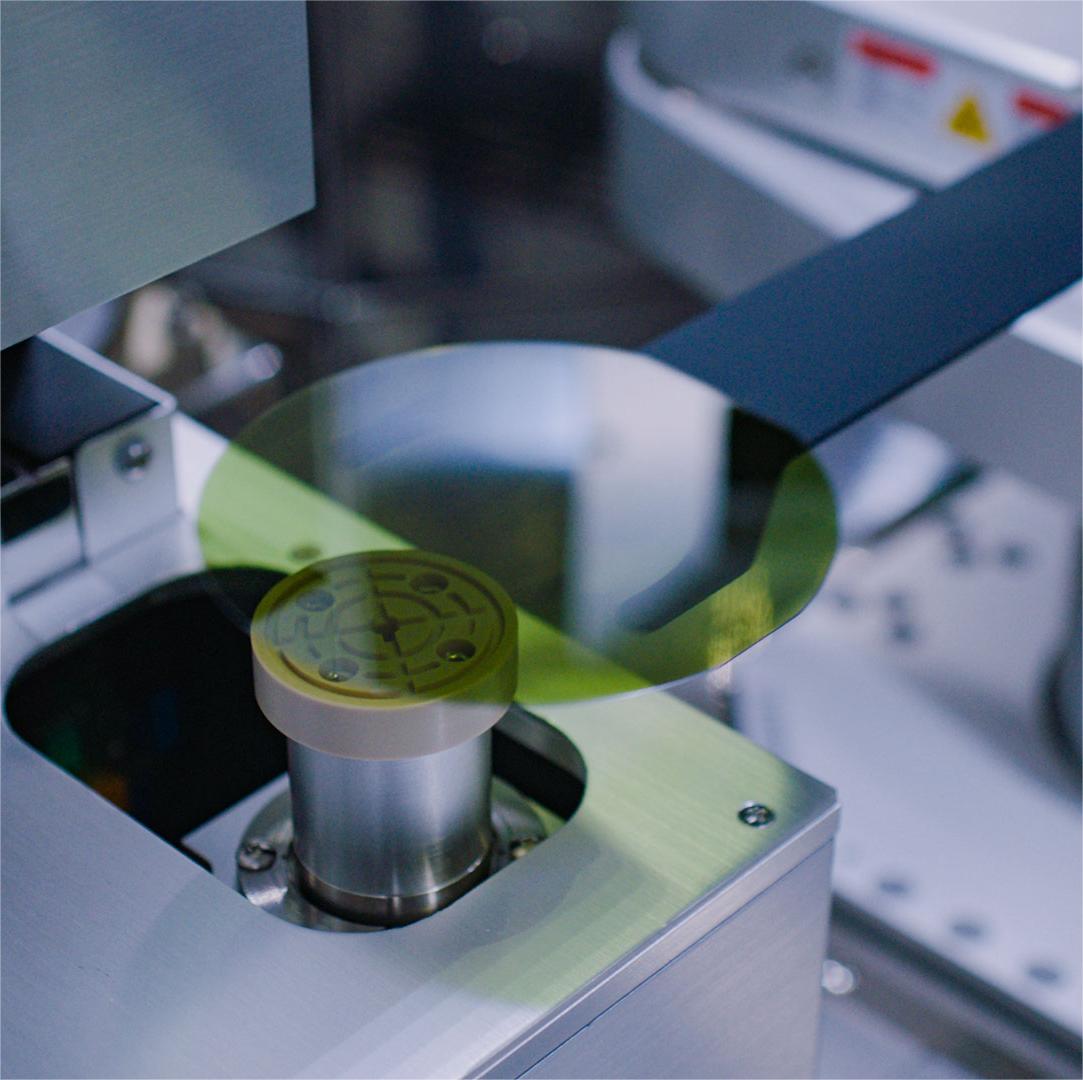
1. TED&TSD
Kedua-dua kehelan berulir (TSD) dan kehelan tepi berulir (TED) berjalan di sepanjang paksi pertumbuhan [0001] dengan vektor Burger berbeza masing-masing <0001> dan 1/3<11-20>.
Kedua-dua TSD dan TED boleh memanjang dari substrat ke permukaan wafer dan menghasilkan ciri permukaan kecil seperti lubang. Biasanya, ketumpatan TED adalah kira-kira 8,000-10,000 1/cm2, iaitu hampir 10 kali ganda daripada TSD.
Semasa proses pertumbuhan epitaxial SiC, TSD memanjang dari substrat ke lapisan epitaxial TSD yang dilanjutkan boleh berubah menjadi kecacatan lain pada satah substrat dan merambat sepanjang paksi pertumbuhan.
Telah ditunjukkan bahawa semasa pertumbuhan epitaxial SiC, TSD diubah menjadi kerosakan lapisan susun (SF) atau kecacatan lobak merah pada satah substrat, manakala TED dalam lapisan epitaxial ditunjukkan berubah daripada BPD yang diwarisi daripada substrat semasa pertumbuhan epitaxial.
2. BPD
Dislokasi satah basal (BPD), yang terletak dalam satah [0001] kristal SiC, mempunyai vektor Burger 1/3 <11-20>.
BPD jarang muncul pada permukaan wafer SiC. Ini biasanya tertumpu pada substrat pada ketumpatan 1500 1/cm2, manakala ketumpatannya dalam lapisan epitaxial hanya kira-kira 10 1/cm2.
Difahamkan bahawa ketumpatan BPD berkurangan dengan peningkatan ketebalan substrat SiC. Apabila diperiksa menggunakan photoluminescence (PL), BPD menunjukkan ciri linear. Semasa proses pertumbuhan epitaxial SiC, BPD yang dilanjutkan boleh diubah menjadi SF atau TED.
Daripada perkara di atas, adalah jelas bahawa kecacatan terdapat pada wafer substrat SiC. Kecacatan ini boleh diwarisi dalam pertumbuhan epitaxial filem nipis, yang boleh menyebabkan kerosakan maut pada peranti SiC. Ini boleh menyebabkan kehilangan kelebihan SiC seperti medan kerosakan yang tinggi, voltan songsang yang tinggi, dan arus bocor yang rendah. Tambahan pula, ini boleh mengurangkan kadar kelayakan produk dan menimbulkan halangan besar kepada perindustrian SiC kerana kebolehpercayaan yang berkurangan.




