
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
SiGe dalam Pembuatan Cip: Laporan Berita Profesional
Evolusi Bahan Semikonduktor
Dalam bidang teknologi semikonduktor moden, dorongan tanpa henti ke arah pengecilan telah menolak had bahan berasaskan silikon tradisional. Untuk memenuhi permintaan untuk prestasi tinggi dan penggunaan kuasa yang rendah, SiGe (Silicon Germanium) telah muncul sebagai bahan komposit pilihan dalam pembuatan cip semikonduktor kerana sifat fizikal dan elektriknya yang unik. Artikel ini mengupas tentangproses epitaksiSiGe dan peranannya dalam pertumbuhan epitaxial, aplikasi silikon tegang, dan struktur Gate-All-Around (GAA).
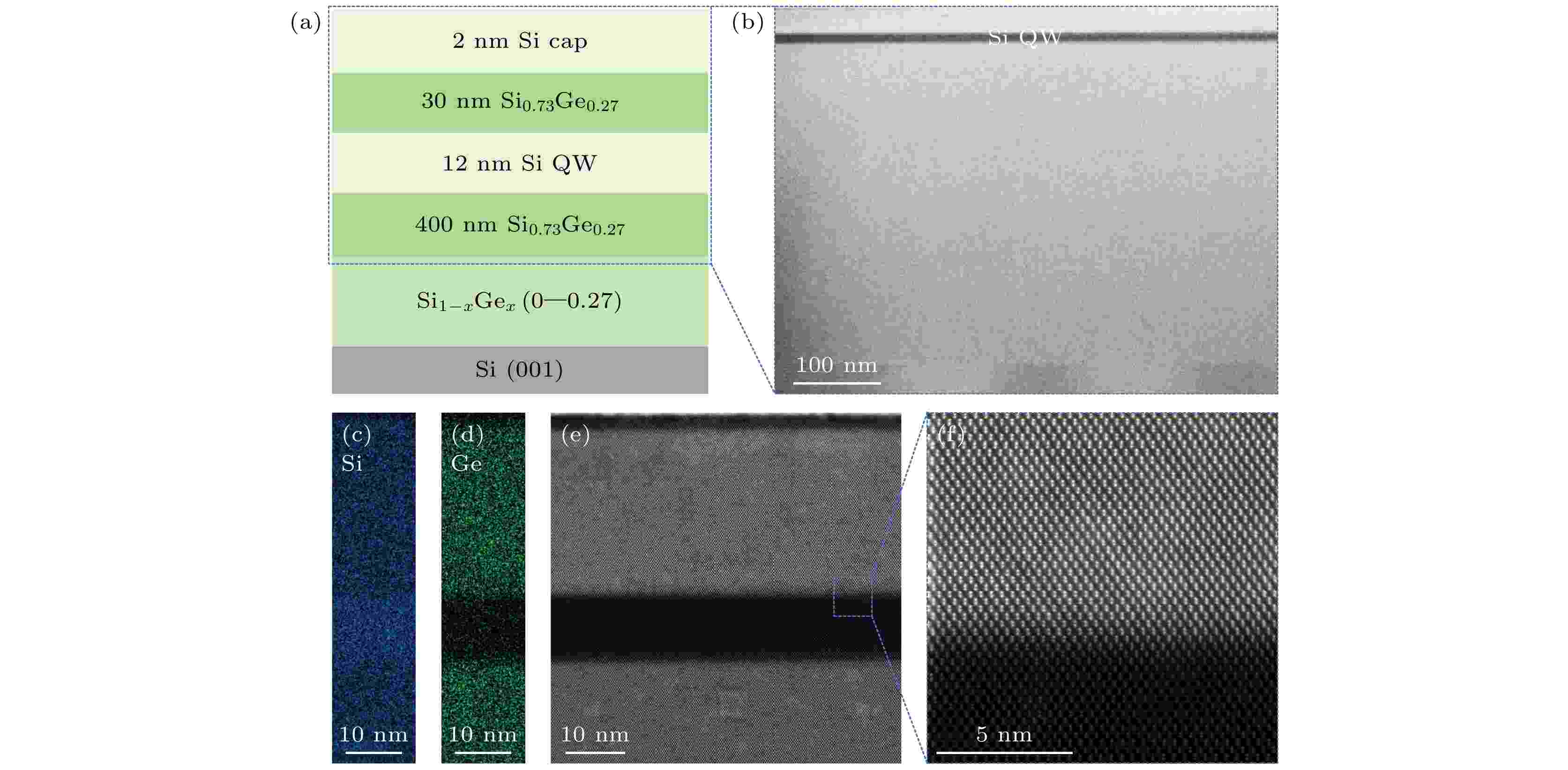
Kepentingan SiGe Epitaxy
1.1 Pengenalan kepada Epitaksi dalam Pembuatan Cip:
Epitaksi, sering disingkat sebagai Epi, merujuk kepada pertumbuhan lapisan kristal tunggal pada substrat kristal tunggal dengan susunan kekisi yang sama. Lapisan ini boleh sama adahomoepitaxial (seperti Si/Si)atau heteroepitaxial (seperti SiGe/Si atau SiC/Si). Pelbagai kaedah digunakan untuk pertumbuhan epitaxial, termasuk Molecular Beam Epitaxy (MBE), Ultra-High Vacuum Chemical Vapor Deposition (UHV/CVD), Atmospheric and Reduced Pressure Epitaxy (ATM & RP Epi). Artikel ini memberi tumpuan kepada proses epitaksi silikon (Si) dan silikon-germanium (SiGe) yang digunakan secara meluas dalam pengeluaran litar bersepadu semikonduktor dengan silikon sebagai bahan substrat.
1.2 Kelebihan SiGe Epitaxy:
Menggabungkan bahagian tertentu germanium (Ge) semasaproses epitaksimembentuk lapisan kristal tunggal SiGe yang bukan sahaja mengurangkan lebar celah jalur tetapi juga meningkatkan frekuensi potong (fT) transistor. Ini menjadikannya boleh digunakan secara meluas dalam peranti frekuensi tinggi untuk komunikasi wayarles dan optik. Selain itu, dalam proses litar bersepadu CMOS lanjutan, ketidakpadanan kekisi (kira-kira 4%) antara Ge dan Si memperkenalkan tegasan kekisi, meningkatkan mobiliti elektron atau lubang dan dengan itu meningkatkan arus tepu peranti dan kelajuan tindak balas.
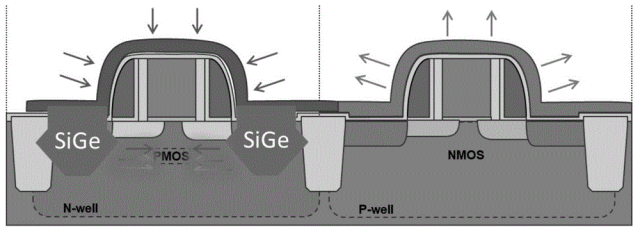
Aliran Proses Epitaksi SiGe Komprehensif
2.1 Pra-rawatan:
Wafer silikon diprarawat berdasarkan hasil proses yang diingini, terutamanya melibatkan penyingkiran lapisan oksida semula jadi dan kekotoran pada permukaan wafer. Untuk wafer substrat yang didop dengan berat, adalah penting untuk mempertimbangkan sama ada pengedap belakang diperlukan untuk mengurangkan auto-doping semasa proses berikutnya.pertumbuhan epitaksi.
2.2 Gas dan Keadaan Pertumbuhan:
Gas silikon: Silane (SiH₄), Dichlorosilane (DCS, SiH₂Cl₂), dan Trichlorosilane (TCS, SiHCl₃) ialah tiga sumber gas silikon yang paling biasa digunakan. SiH₄ sesuai untuk proses epitaksi penuh suhu rendah, manakala TCS, yang terkenal dengan kadar pertumbuhan pesatnya, digunakan secara meluas untuk penyediaan tebalepitaksi silikonlapisan.
Gas Germanium: Germane (GeH₄) ialah sumber utama untuk menambah germanium, digunakan bersama dengan sumber silikon untuk membentuk aloi SiGe.
Epitaksi terpilih: Pertumbuhan terpilih dicapai dengan melaraskan kadar relatif bagipemendapan epitaxialdan etsa in situ, menggunakan DCS gas silikon yang mengandungi klorin. Selektiviti adalah disebabkan oleh penjerapan atom Cl pada permukaan silikon yang kurang daripada pada oksida atau nitrida, memudahkan pertumbuhan epitaxial. SiH₄, kekurangan atom Cl dan dengan tenaga pengaktifan yang rendah, biasanya digunakan hanya untuk proses epitaksi penuh suhu rendah. Satu lagi sumber silikon yang biasa digunakan, TCS, mempunyai tekanan wap yang rendah dan cecair pada suhu bilik, memerlukan H₂ menggelegak untuk memasukkannya ke dalam ruang tindak balas. Walau bagaimanapun, ia agak murah dan sering digunakan untuk kadar pertumbuhan pesatnya (sehingga 5 μm/min) untuk mengembangkan lapisan epitaksi silikon yang lebih tebal, digunakan secara meluas dalam pengeluaran wafer epitaksi silikon.
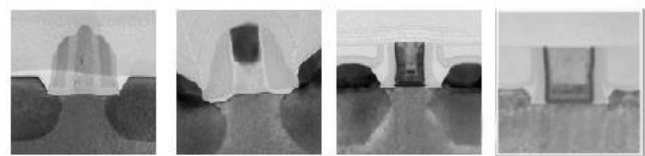
Silikon Tertekan dalam Lapisan Epitaxial
semasapertumbuhan epitaxial, Si kristal tunggal epitaxial dimendapkan pada lapisan SiGe yang santai. Disebabkan oleh ketidakpadanan kekisi antara Si dan SiGe, lapisan kristal tunggal Si tertakluk kepada tegasan tegangan daripada lapisan SiGe yang mendasari, dengan ketara meningkatkan mobiliti elektron dalam transistor NMOS. Teknologi ini bukan sahaja meningkatkan arus tepu (Idsat) tetapi juga meningkatkan kelajuan tindak balas peranti. Untuk peranti PMOS, lapisan SiGe ditanam secara epitaxial di kawasan sumber dan longkang selepas goresan untuk memperkenalkan tegasan mampatan pada saluran, meningkatkan mobiliti lubang dan meningkatkan arus tepu.
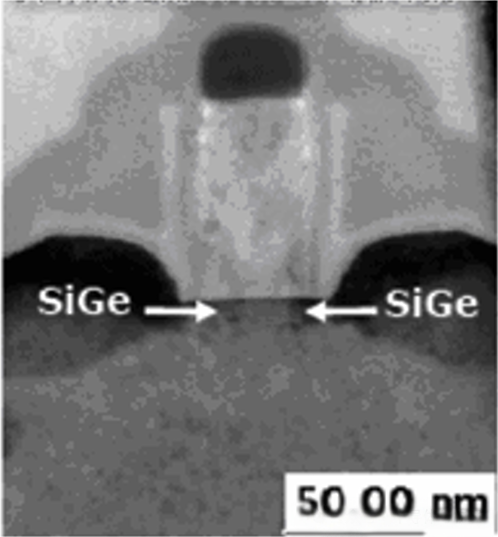
SiGe sebagai Lapisan Pengorbanan dalam Struktur GAA
Dalam pembuatan transistor wayar nano Gate-All-Around (GAA), lapisan SiGe bertindak sebagai lapisan pengorbanan. Teknik etsa anisotropik selektiviti tinggi, seperti etsa lapisan kuasi-atom (kuasi-ALE), membolehkan penyingkiran tepat lapisan SiGe untuk membentuk struktur nanowire atau nanosheet.
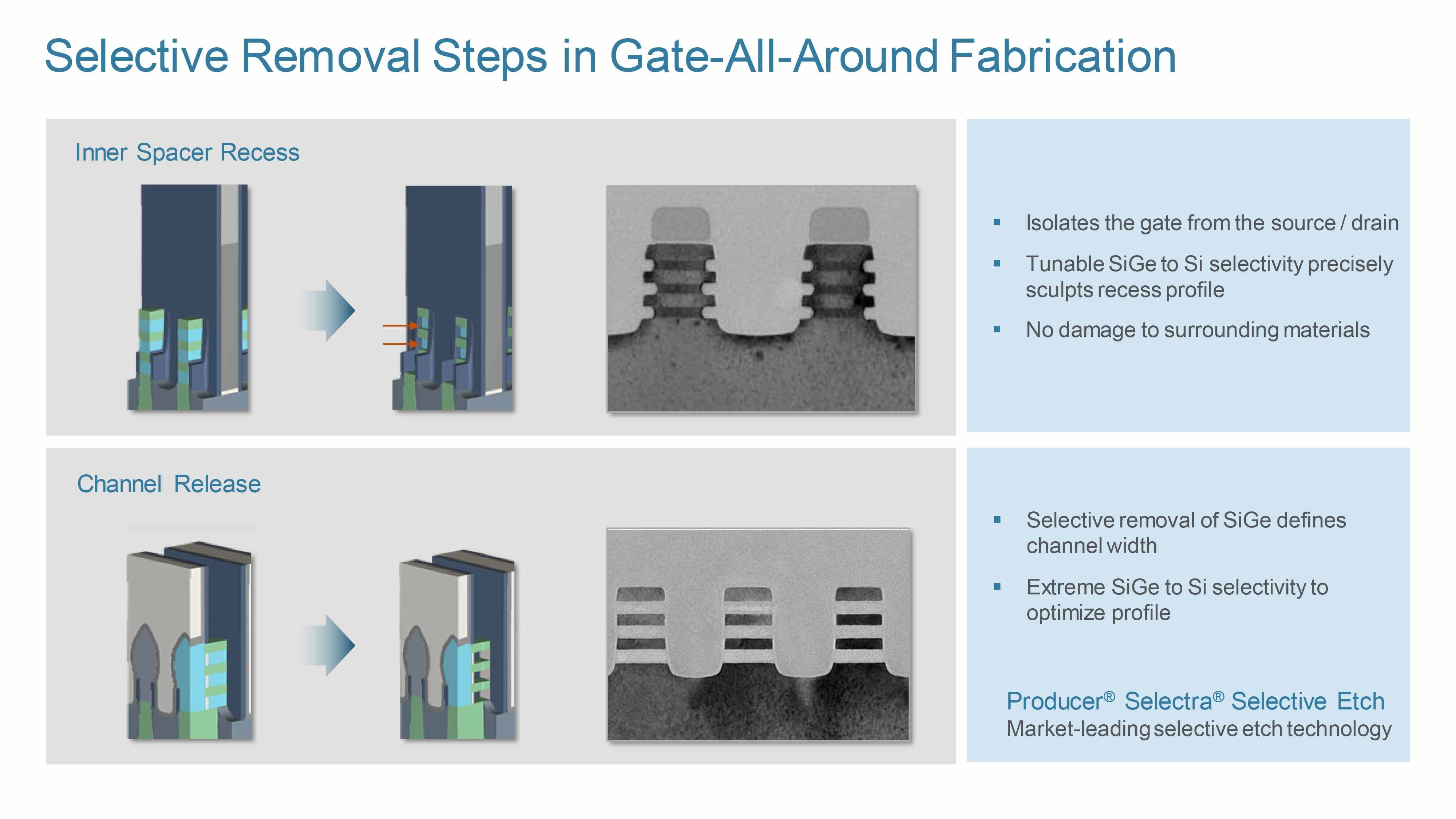
Kami di Semicorex pakar dalamLarutan grafit bersalut SiC/TaCdigunakan dalam pertumbuhan epitaxial Si dalam pembuatan semikonduktor, jika anda mempunyai sebarang pertanyaan atau memerlukan butiran tambahan, sila jangan teragak-agak untuk menghubungi kami.
Telefon untuk dihubungi: +86-13567891907
E-mel: sales@semicorex.com




